Лазер на основе многопроходной тонкопленочной P-N-гетероструктуры
Научная библиотека 24.03.2017 Комментариев к записи Лазер на основе многопроходной тонкопленочной P-N-гетероструктуры нетУ.Бекирев, С.Бабенко, В.Крюков, Б.Потапов, А.Скипер // Журнал: Электроника: наука, технология, бизнес , спецвыпуск (00137) 2014, с: 130-136.
Впервые исследованы полупроводниковые инжекционные лазеры на основе многопроходных тонкопленочных p-n-гетероструктур. Тонкопленочная многопроходная лазерная p-n-гетероструктура толщиной 13–30 мкм была посажена на подложку-носитель. Экспериментальные исследования решетки лазеров на основе тонкопленочных p-n-гетероструктур касались спектров излучения, пороговых токов и внешних квантовых выходов. В тонкопленочном многопроходном лазере были получены внешние квантовые выходы 77% при Т=300К и более 90% при Т=77К. Полученные результаты исследований были приведены в сравнение с аналогичными результатами для решетки лазеров на основе нетонкопленочной многопроходной p-n-гетероструктуры. Показано улучшение параметров многопроходных тонкопленочных лазеров над нетонкопленочными.
Развитие современных оптоэлектронных систем передачи, записи, считывания информации невозможно без совершенствования полупроводниковых лазеров. Наиболее эффективными являются инжекционные лазеры на основе многопроходных р-n-гетероструктур. Дальнейшее улучшение характеристик лазеров можно получить при переходе к тонкопленочным многопроходным р-n-гетероструктурам. В настоящей статье впервые представлены результаты исследования полупроводниковых инжекционных лазеров на основе таких гетероструктур. В решетках тонкопленочных многопроходных лазеров достигнуты значения параметров, превосходящие параметры нетонкопленочных многопроходных лазеров. ЭФФЕКТИВНЫЕ ЛАЗЕРЫ*
Наиболее эффективные излучающие полупроводниковые приборы изготавливаются на основе многопроходных p-n-гетероструктур в системе соединений А3В5. Это связано с тем, что в результате многократных проходов излучения внутри гетероструктуры его интенсивность может многократно возрастать, значительно увеличивая тем самым и выход излучения наружу. При этом накопленное в структуре излучение может испытывать частичное самопоглощение в активной области структуры и последующее переизлучение в ней. Самопоглощение и переизлучение приводят к увеличению концентрации неосновных носителей в активной области излучающего прибора, которая может оказаться значительно выше концентрации носителей заряда, образуемой в результате их инжекции через p-n-переход. Это обстоятельство позволяет улучшать характеристики полупроводниковых излучающих приборов на основе многопроходной p-n-гетероструктуры [1–3].
Об уменьшении пороговых токов экспериментальных инжекционных лазеров на основе многопроходных p-n-гетероструктур более чем в пять раз впервые сообщили французские исследователи [4]. Затем в НИИФП также экспериментально было показано, что пороговые токи инжекционного лазера на основе многопроходной p-n-гетероструктуры уменьшались в три – пять раз, а внешний квантовый выход возрастал с 15–20 до 60% при 300К и до 80% при 77–150К [5]. В лазерах на основе многопроходных p-n-гетероструктур значительно увеличился динамический диапазон рабочих токов и мощностей излучения, улучшился теплоотвод за счет большей мощности полезного излучения, выводимого из кристалла [5, 6]. Лазеры, рассматривавшиеся в указанных публикациях, изготавливались на основе выращенных жидкофазной эпитаксией гетероструктур с толщиной активной области, равной десятым долям микрометра. Пороговые и рабочие токи таких лазеров были относительно высокими. Для усиления эффектов переизлучения в активной области и улучшения характеристик излучающих приборов в НИИФП были предложены гетероструктуры с дополнительным узкозонным слоем в активной области [7–11]. Эти гетероструктуры были несколько усовершенствованы и названы гетероструктурами с внутренним усилением инжекции. Их применение в многопроходных инжекционных лазерах позволило увеличить внешний квантовый выход до 65% и более при 300К и до 85% при 77–200К [12, 13]. В гетероструктурах с дополнительным слоем обнаружилось очень полезное для излучающих приборов явление – самоохлаждение их активной области [13]. Наблюдавшееся экспериментально снижение температуры оценивалось примерно в 30°С. По этой причине применение оптимизированных под самоохлаждение излучающих гетероструктур с внутренним усилением инжекции перспективно как для светодиодов, так и для лазеров.
Приведенные значения внешнего квантового выхода, полученные в 1980–1990-е годы, были рекордными. Дальнейшее повышение внешнего квантового выхода в лазерах было достигнуто при переходе к многопроходным гетероструктурам, в которых в слой волновода и одновременно в переизлучающий активный слой микронных размеров была встроена квантовая яма. Такая гетероструктура была нами запатентована [14]. В решетке лазеров на основе такой гетероструктуры, выращенной методом MOCVD на GaAlAs-подложке толщиной ~120 мкм, мы получили внешний квантовый выход более 90% при Т = 77К [15]. Однако при 300К внешний квантовый выход этого лазера не превышал 50%. По нашему мнению, это связано с малой глубиной квантовой ямы (менее 0,15 эВ). В результате при 300К из нее мог происходить значительный термический выброс носителей заряда и, кроме того, носители заряда в переизлучающем слое активной области вследствие неконтролируемой сильной перекомпенсации легирующими примесями могли в значительной степени рекомбинировать через хвосты плотности состояний. Энергия квантов при такой рекомбинации понижена,
поэтому эффекты самопоглощения и переизлучения не были интенсивными. Следует заметить, что высокий внешний квантовый выход более 90% при температуре 77К является следствием проявления тонкопленочности у нетонкопленочного лазера.
При низкой температуре произошло значительное уменьшение концентрации носителей заряда во всех слоях гетероструктуры за счет их вымораживания, что эквивалентно уменьшению толщины протяженных ограничивающих слоев и уменьшению поглощения излучения в них свободными носителями заряда при 300К. Кроме того, при 77К внутренний квантовый выход был примерно равен единице, интенсивность рекомбинации через хвосты плотности состояний ослабевала, поэтому эффекты самопоглощения и переизлучения стали более интенсивными. Все это и позволило получить высокий внешний квантовый выход и указало путь к повышению излучательных характеристик лазеров, а именно – улучшение параметров переизлучения в активной области и уменьшение толщины ограничивающих слоев гетероструктуры.
Объединение конструкций гетероструктур, защищенных указанными выше пятью авторскими свидетельствами [7–11], с конструкцией гетероструктуры с квантовой ямой также защищенной патентом [14], позволило получить новый тип излучающих многопроходных гетероструктур, попадающих под классификацию гетероструктур с внутренним усилением инжекции. Этот новый тип многопроходных гетероструктур был запатентован [16]. В них сохранен эффект самоохлаждения активной области. Они могут оказаться перспективными в дальнейших разработках.
Но работы по улучшению характеристик обычных немногопроходных лазеров продолжались и имели определенный успех. В России были созданы экспериментальные лазеры на основе асимметричных InGaAsP/InP-гетероструктур с внешним квантовым выходом 60% и более [17, 18]. Ранее за рубежом внешний квантовый выход, равный 60%, был получен в мощных лазерах на основе гетероструктур с расширенным волноводом [19]. Что касается целенаправленных и осмысленных работ по инжекционным лазерам на основе излучающих многопроходных p-n-гетероструктур и посвященных им других публикаций, кроме публикаций НИИФП, нам не известно. Хотя, по-видимому, эффект многопроходности присутствует, например, в лазерах на основе асимметричных InGaAsP/InP-гетероструктур раздельного ограничения [17].
В целом можно заметить, что в перспективе рабочие и максимальные мощности лазеров на основе многопроходных гетероструктур окажутся выше, чем лазеров без многопроходности. Связано это с тем, что дальнейшее совершенствование лазеров на основе многопроходных гетероструктур возможно за счет устранения поглощения излучения на свободных носителях в излучающем кристалле. Поглощение может быть существенным, если толщина легированных слоев многопроходной гетероструктуры составляет 100–200 мкм и более. Но при такой толщине гетероструктуры сложно изготовить светодиод, например, с внешним квантовым выходом более 30–35% или инжекционный лазер либо c повышенным внешним квантовым выходом, либо с пониженными рабочими токами.
Специалистами фирмы ОSRAM (Германия) для уменьшения потерь излучения в кристалле многопроходной гетереоструктуры на свободных носителях и увеличения внешнего квантового выхода светодиодов предложено изготавливать тонкопленочные светодиоды. Предлагалось уменьшить толщину кристалла до 5–50 мкм [20, 21]. Сообщается, что внешний квантовый выход таких светодиодов превысил 40%, а световая отдача составила 100 лм/Вт [22]. Разработчики OSRAM намерены превзойти полученный результат и довести квантовый выход до 75–80% [23].
ТОНКОПЛЕНОЧНЫЕ ЛАЗЕРЫ
Создание тонкопленочных многопроходных лазеров в НИИФП началось с разработки конструкции такого лазера, способа его изготовления и патентования [24, 25]. Для уменьшения порогового тока при переизлучении была выращена многопроходная излучающая гетероструктура с квантовой ямой в активной переизлучающей области, которая одновременно является и волноводом [15]. GaAlAs p-n-гетероструктуры выращивались методом MOCVD на GaAs- и GaAlAs-подложках. Толщина GaAlAs-подложки составляла 120–150 мкм, содержание AlAs – не менее 15% мол. Подложки выращивались методом жидкофазной эпитаксии. Общая толщина выращенных методом MOCVD излучающих GaAlAs p-n-гетероструктур была равна ~13–16 мкм, толщина области переизлучения – ~0,3 или 1 мкм. Область переизлучения легировалась цинком до концентрации (5–7)·1017 см-3, содержание AlAs в ней составляло ~10% мол. В середине каждой области переизлучения находилась слаболегированная GaAs-квантовая яма толщиной ~50–70 Å и глубиной ~130 мэВ. Ограничивающие p- и n-слои легировались соответственно цинком и кремнием до концентраций ~8·1017 см-3, содержание AlAs составляло ~35% мол. На рис.1 приведены распределения алюминия, цинка и кремния, снятые с помощью вторично-ионного микрозонда IMS-4F компании САМЕСА. Из распределения алюминия видно, что наличие квантовой ямы четко проявилось в распределении примесей (разрешение не хуже 10 Å).
Для оценки основных характеристик излучающих гетероструктур изготавливались следующие решетки лазеров:
• немногопроходные на GaAs-подложке;
• многопроходные нетонкопленочные на GaAlAs-подложке;
• многопроходные тонкопленочные.
По конструкции решеток тонкопленочный многопроходный лазер был идентичен немногопроходному и многопроходному нетонкопленочному лазерам, описанным в литературе [5, 6].
Гетероструктура тонкопленочного лазера изготавливалась на подложке из арсенида галлия с пониженной плотностью дислокаций. Это было необходимо для обеспечения минимального дефектообразования в активной области гетероструктуры при термических процессах. Толщина излучающей гетеростуктуры составляла 13–16 мкм. На поверхности гетероструктуры методами фотолитографии изготавливались омические контакты в виде полосок шириной 3–5 мкм с шагом 15 мкм. Между контактами оставался слой окисла, а затем поверх контактов и окисла наносилось металлическое (золотое) покрытие. В результате на поверхности гетероструктуры между полосковыми контактами возникало зеркальное покрытие для отражения спонтанного излучения из активной области.
На позолоченную поверхность напаивалась арсенидгаллиевая или кремниевая пластина толщиной более 100 мкм. Обе стороны напаиваемой пластины имели омические контакты. Такая пластина, названная подложкой-носителем, обеспечивала механическую прочность и электрическую проводимость прибора (рис.2). Толщина слоя припоя выбиралась так, чтобы обеспеччить минимальные значения напряжения между слоями кристалла-излучателя, возникающего при термических процессах. В патенте [26] рекомендуемая толщина припоя – не более 0,1 мкм. Однако в рассматриваемом случае толщина могла быть и больше, с тем чтобы припой мог полностью компенсировать возможные неровности поверхности эпитаксиальной p-n-гетероструктуры. В качестве припоя рекомендуется применять сплав золота и серебра с температурой плавления 450–500°С. Эта температура должна быть на несколько десятков градусов выше температуры вжигания омических контактов. После напайки подложки-носителя исходная подложка арсенида галлия, на которой выращивалась излучающая p-n-гетероструктура, удалялась химическим травлением. На освободившуюся поверхность GaAlAs излучающей гетероструктуры также наносились полосковые омические контакты и проводилось их вжигание импульсным фотонным поверхностным нагревом. Это позволяло сохранить выполненное ранее паяное соединение излучающей структуры и подложки-носителя. При фотонном нагреве вместо припоя можно использовать высокотемпературный проводящий клей, например Н20Е. Теплопроводность клея хуже, чем припоя, но зато он обеспечивает минимальные значения напряжения между подложкой-носителем и гетероструктурой при термических процессах.
Ширина многопроходной области и площадь p-n-перехода лазера, задаваемая числом полосковых контактов (нами изготавливалось до восьми контактов), выделялись канавками, сформированными травлением излучающей гетероструктуры на всю ее толщину вдоль боковых полосковых контактов. На канавки и всю поверхность структуры наносился слой окисла. С контактов окисел удалялся, и вся поверхность покрывалась металлической пленкой, которая образовывала между контактами зеркала для обеспечения отражения внутреннего спонтанного излучения. Лазерные кристаллы разделяли скрайбированием со стороны подложки-носителя и последующим раскалыванием структуры по канавкам скрайбирования. Образцы чипов лазеров с длиной резонатора Фабри-Перо в пределах 200–800 мкм выкалывались перпендикулярно полосковым контактам из созданных структур (рис.2). Нами исследовались чипы с площадью p-n-перехода до ~250×600 мкм.
Лазерное излучение в решетках многопроходных лазеров возникало как под полосковыми контактами, так и между ними. Как показали наблюдения картины ближнего поля в ИК-микроскопе, увеличение выходной мощности лазерного излучения с увеличением тока сопровождалось расширением как существующих каналов генерации, так и ростом их числа. При токах, превышающих пороговый ток в 1,5–2 раза, картина свечения на грани резонатора, как правило, состояла из двух наиболее ярких точек, расположенных у краев двух соседних полосковых контактов, между которыми находились еще по две точки за пределами этих контактов с в 1,5–4 раза меньшим свечением. Расположение точек на грани резонатора было близким к эквидистантному.
Однородность картины ближнего поля тонкопленочного многопроходного лазера при 300К в каналах лазерной генерации была больше, чем в каналах нетонкопленочного лазера. Это свидетельствует о более равномерных процессах переизлучения и накопления носителей заряда в активной области под всей поверхностью p-n-перехода. Следует заметить, что картина ближнего поля сильно зависела от качества сколов резонаторных граней. Это в большей мере относилось к тонкопленочным образцам, где сколы производились через металлизированные слои подложки-носителя и припоя.
При 300К длина волны излучения многопроходных лазеров составляла ~860 нм (рис.3), при 80К – ~830 нм. Спектр излучения лучших образцов был характерным для решеток лазеров с гетероструктурой, описанной в литературе [5, 15], и состоял из одной полосы полушириной 1,5–2 Å. Длина волны 860 нм для квантовой ямы толщиной ~7 нм ближе всего соответствует рекомбинационным переходам носителей с уровня электронов на верхний уровень тяжелых дырок в яме.
Для снятия ватт-амперных характеристик лазеров с толщиной области переизлучения ~1 мкм (структуры с такой волноводной областью называют структурами с расширенным волноводом [27]) при токах более 1,5–2 А во избежание разогрева чипов на лазеры подавались импульсы питания длительностью 0,1–0,2 мкс с частотой повторения до 100 Гц. При 300К внешний квантовый выход лазера на основе решетки с неудаленной GaAs-подложкой, в котором многопроходность отсутствовала, едва достигал 27–30% (рис.4, кривая 1). Характеристика 2 на рис.4 соответствует многопроходному нетонкопленочному лазеру при 300 К. Его квантовый выход превысил 65%. Характеристика 3 – многопроходному тонкопленочному лазеру при 300К. Его внешний квантовый выход достигал 77%. Характеристика 4 соответствует многопроходному тонкопленочному лазеру при 77К. Для него был получен наибольший внешний квантовый выход, равный 90–92%. Такой же примерно внешний квантовый выход наблюдался нами и ранее, но для обычного нетонкопленочного многопроходного лазера [15]. Это связано с тем, что при такой температуре коэффициенты поглощения излучения свободными носителями настолько малы, что при различии толщины кристаллов-излучателей в 100–200 мкм разница в квантовых выходах не превышает 1–2%. При значениях внутреннего квантового выхода в активных областях обоих лазеров, близких к единице, интенсивности накопленного излучения и величины накопленного заряда становятся почти равными. По этой же причине различие в значениях внешнего квантового выхода тонкопленочного и нетонкопленочного лазеров мало.
Подобную ситуацию, вероятно, можно получить и при комнатной температуре. Для этого необходимо уменьшать толщину излучающей p-n-гетероструктуры, например до 5 мкм, как и предлагала фирма ОSRAM [20, 21]. В такой структуре возрастают интенсивность излучения внутри кристалла лазера и накопленный заряд в активной области. Это позволяет при меньших токах перейти к квадратичной рекомбинации в этой области и получить внутренний квантовый выход, близкий к единице. Другой вариант – для создания высокоэффективного лазера использовать гетероструктуру с внутренним усилением инжекции. В этом случае можно реализовать в весьма малом объеме излучающую многопроходную p-n-гетероструктуру толщиной менее 5 мкм [28].
Следует заметить, что при питании лазера более короткими и более мощными токовыми импульсами, очевидно, можно получить еще большие внешние квантовые выходы. Все это позволяет говорить о возможности почти полного преобразования электрической энергии в лазерное излучение. Публикации о столь высоких результатах для лазеров на основе многопроходных гетероструктур нам не известны.
Из детального анализа рис.4 следует, что в диапазоне токов 1-2 А дифференциальный квантовый выход превышает 100%. Этот параметр определялся как отношение приращения числа квантов лазерного излучения, выводимых наружу, к соответствующему приращению числа электронов в токе накачки. На упомянутых участках прирост квантов лазерного излучения, выводимых наружу, превосходит добавленную концентрацию электронов, инжектируемых током через p-n-переход. Согласно экспериментальным данным [5] и теоретическому анализу [15], это свидетельствует об эффективном преобразовании спонтанного излучения в лазерное.
Из характеристики 1 видно, что в многопроходном нетонкопленочном лазере с квантовой ямой пороговый ток примерно в три раза ниже, чем в таком же лазере, но без квантовой ямы, описанном ранее [5, 15]. Обсуждение этого уменьшения порогового тока [27, 15] показало, что термический выброс носителей с уровня рекомбинации в квантовой яме не позволил еще больше уменьшить пороговую плотность тока. Для предотвращения термического выброса необходимо делать более глубокую квантовую яму. Это проще выполнить, например, в GaAlInP-гетероструктурах. Однако такой промышленной технологии в России практически нет. Тем не менее пороговый ток тонкопленочного лазера уменьшается более значительно, чем нетонкопленочного лазера. Чем меньше пороговый ток при многопроходности, тем больше диапазон рабочих токов и внешний квантовый выход лазеров. Диапазон рабочих токов расширяется не только за счет уменьшения порогового тока, но и за счет увеличения верхней границы рабочих токов. При высоком внешнем квантовом выходе больше тепла отводится лазерным излучением, отодвигая тем самым перегрев кристалла в сторону больших токов.
* * *
В итоге можно сказать, что рабочие и предельные параметры тонкопленочных многопроходных лазеров оказываются лучше, чем просто многопроходных лазеров. Кроме того, имеются предпосылки для дальнейшего улучшения параметров тонкопленочных лазеров на основе гетероструктур с внутренним усилением инжекции. Правда, это связано с усложнением технологии. Возможно, в этом и состоит новый этап совершенствования полупроводниковых излучающих приборов. Открывается возможность почти полного преобразования электрической энергии в излучение. Достигнутые значения внешнего квантовоговыхода в 77% при 300К являются очень высокими, а более 90% при 77К – рекордными.
Источник: http://www.electronics.ru/files/article_pdf/4/article_4753_704.pdf

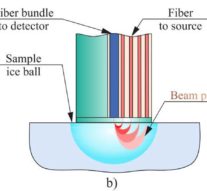

Leave a comment
You must be logged in to post a comment.